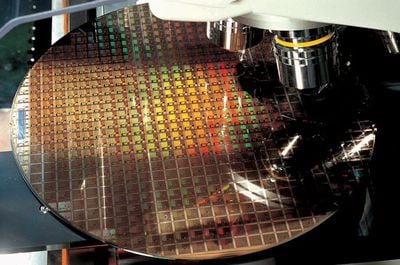
SoIC (System on Integrated Chip) 技术由台积电 (TSMC) 开发,并于 2018 年首次亮相。它允许芯片以三维结构堆叠,与传统的二维芯片设计相比,提供更高的电气性能和热管理能力。
据《经济日报》报道,苹果公司已扩大与台积电的合作,共同开发下一代混合 SoIC 封装技术,该技术还结合了热塑性碳纤维复合材料模塑技术。据悉,该封装技术目前处于小规模试生产阶段,计划于 2025 年和 2026 年进行大规模生产,用于新的 Mac 电脑和 AI 云服务器。
苹果官方代码中已经发现了疑似 M5 芯片的代码。苹果一直在使用台积电的 3 纳米制程,开发用于自身 AI 服务器的处理器,目标是在 2025 年下半年开始大规模生产。然而,据海通证券分析师 Jeff Pu 表示,苹果计划在 2025 年下半年组装搭载 M4 芯片的 AI 服务器。
目前,苹果公司的 AI 云服务器据信运行在多个连接的 M2 Ultra 芯片上,而 M2 Ultra 芯片最初仅为桌面 Mac 电脑设计。一旦 M5 芯片被采用,其先进的双重用途设计被视为苹果未来对其 AI 功能垂直整合供应链计划的标志,该计划将覆盖电脑、云服务器和软件。
(注:本文部分内容参考 Digitimes.com。)

